산화막
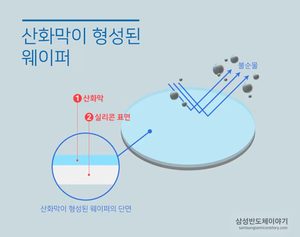
산화막(酸化膜, Oxide Film, Silicon dioxide film)은 금속 또는 반도체가 산소와 반응해서 생성되는 엷은 막이다.
반도체 공업에서는 실리콘 단결정이 각종 트랜지스터의 재료이며, 실리콘 산화막을 간단히 산화막이라 한다. 이 막은 실리콘을 약 1000℃의 산소 또는 수증기 중에 두면 생성된다. 구조는 녹아 있는 석영(石英)과 같은 유리 상태에서 실리콘과 산소가 그물코 모양으로 되어 있다. 절연성이 높고 화학적으로 안정되어 있어서 트랜지스터 제작 시 실리콘 결정에 함유된 각종 불순물의 확산 방지에도 사용된다.
목차
개요[편집]
산화막은 공정에서 발생하는 불순물로부터 실리콘 표면을 보호하는 막이다.
고온에서 산소를 실리콘 웨이퍼 표면과 화학 반응시켜 생성되는 얇고 균일한 실리콘 산화막(SiO2)이다.
특히 눈에 보이지 않는 미세한 오염물질도 집적회로의 전기적 특성에 영향을 미칠 수 있기 때문에, 공정 시 발생하는 불순물로부터 웨이퍼를 보호하는 산화막의 역할이 매우 중요하다. 또한 산화막은 웨이퍼 위에 그려지는 각 배선이 합선되지 않도록 구분해주는 절연막 역할을 하기도 한다.
일반적으로 산화막 형성 방법에는 여러 가지가 있지만, 고온을 이용한 열산화 공정이 보편적으로 사용된다.
웨이퍼에 산화막 형성 방법[편집]
- 1. 열산화(Thermal Oxidation)
열산화 방법은 산화반응에 사용되는 기체에 따라 건식산화(Dry Oxidation)와 습식산화(Wet Oxidation)로 나뉜다.
- 건식산화(Dry Oxidation) : 산소만을 이용해 얇은 막을 형성할 때 주로 사용한다.
- 매우 좋은 전기적 특성을 가진 산화물을 만들 수 있다.
- 동일한 온도, 같은 두께의 산화물을 형성하는데 습식산화 보다 더 많은 시간이 필요하다.
- 얇은 산화막 성장 : ~200Å(느린산화속도)
- 패드 산화막,게이트 산화막, STI라이너(Liner) 산화막으로 사용
- 습식산화(Wet Oxidation) : 산소와 수증기를 모두 사용하기 때문에 보다 두꺼운 막을 형성할 때 사용한다.
- 산화막 성장속도가 빠르고 동일한 온도와 시간에서 습식산화를 사용하여 얻어진 산화막은 건식산화를 사용한 것보다 약 5~10배 정도 더 두꺼운 막을 형성 할수 있다.
- 건식 산화에 비해 산화층의 밀도가 낮다.
- 두꺼운 산화막 성장 : ~ 수천 Å(빠른산화속도)
- 2. 전기 화학적 산화(Electrochemical Oxdiation)
- 3. 화학적 기상 증착(Chemical Vapor Deposition, CVD)
- 4. 플라즈마 화학 기상 증착 (Plasma Enhanced Chemical Vapor Deposition, PECVD)
산화막의 기능[편집]
- 1. 실리콘 표면 보호 역할
반도체 제조 공정 중에는 여러 가지 의도하지 않는 오염이 발생되는데, 그 중 불순물 (Impurity)에 의해 실리콘의 비저항 또는 전도율이 변화하여 소자의 특성을 떨어트리는 경우가 있어서 직접회로의 전기적 특성에 치명적인 영향을 미치게 된다. 따라서, 산화막은 이 불순물들을 방지하고 소자의 전기적 특성을 보호하며, 먼지, 긁힘, 오염물질로부터 실리콘 표면의 오염을 방지하는데 공정 시 발생하는 불순물로부터 웨이퍼를 보호하는 산화막의 역할이 매우 중요한 것이다.
- 2. 이온주입시의 마스크 역할
- 산화막 이온 주입 : 웨이퍼 표면에 산화막으로 패턴을 형성하고 이온 주입법으로 불순물을 주입할 경우 선택적인 영역에 이온을 주입할수 있다.
- 유기막 이온 주입 : 유기막 패턴을 형성하고 이온 주입할 경우 이온이 유기막을 통과하는 경우 대치하여 사용할 수 있다. 메커니즘은 산화막을 마스크처럼 사용하여 선택적 영역에 이온을 주입하는 것이다.
- 3. 소자분리 역할
소자의 크키가 작아지게 되면 소자분리 영역도 좁아져 기존의 로코스(LOCOS) 기술로는 분리가 불가능하다. 이때 규소(Si)를 식각하고 산화막을 채워 소자를 분리하는데 흔히 STI(Shal low Trench Isolation)이라 불리는 공정 기술을 사용하는데, 트렌치(Trench)라는 도랑안에 채워지는 산화막은 CVD(Chemical Vapor Deposition)방법으로 증착하며, 산화막 증착 전 트렌치 식각 계면을 안정화 시키기 위해 트렌치 측벽에 열 산화막을 형성시킨다. 메커니즘은 산화막으로 채워진 트렌치가 소자1영역과 소자2영역을 절연하여 전기적으로 연결되지 않도록 분리하는 것이다.
- 4. 유전체의 역할
- 트랜지스터의 역할 : 산화막은 전기적 기능을 담당하는 유전체의 역할을 한다.
- 캐패시터의 역할 : 산화막은 수동소자의 하나만 캐패시터 구성요소인 유전체로써, 게이트와 실리콘, 메탈과 메탈사이에 삽입되어 커패시터를 구성한다
열 산화막 형성 방법[편집]
산화 및 확산 장비(Furance)[편집]
실리콘 산화막 형성과 이온 주입후 불순물을 실리콘 내부로 확산 시키는 장비이다.
- 확산 장비의 역할
a. 고온의 챔버 내부에 있는 웨이퍼에 산소가스의 산화 분위기에서 표면에 산화막 형성시킨다.
b. 웨이퍼 표면에 주입된 불순물 이온들의 전기적 활성화 시켜준다.
c. 온도와 시간을 조절하여 주입된 불순물을 소정의 깊이까지 확산할수 있다.
- 장비의 종류
확산장비는 수직형과 수평형 두 가지 종류가 있다.
- 확산장비의 구성
고정밀도로 유량제어된 프로세스 가스를 챔버 내부에 공급 및 챔버 내부의 압력 제어에 필요한 집적화 가스 공급시스템과 프로세스 가스용 밸브, 프로세스 가스용 레귤레이터, 고진공용 밸브, 진공 압력 비례제어 시스템 등으로 구성되어 있다.
- 석영관 로(Quartz-tube Furance) 사용
- 공정온도 : 실리콘(Si) = 800~1200℃
- 소스(Source) : 산소(O₂)
- 반응 메커니즘
- 건식 산화 : 실리콘 웨이퍼(고체) + O₂ -> SIO₂ (고체산화막)
- 습식 산화 : 실리콘 웨이퍼(고체) + 2H₂O -> SiO₂ (고체산화막) + 2H₂
열산화막 공정의 중요한 변수 세가지[편집]
- 온도에 따라 산화막의 두께도 증가한다.
- 압력에 따라 차이가 있다.
- 열산화 하고자 하는 실리콘 기판의 결정방향
참고자료[편집]
- 〈산화막〉, 《IT용어사전》
- 〈산화막〉, 《삼성반도체》
- 경제학계론, 〈반도체 산화공정이란? (Oxidation공정)〉, 《네이버 블로그》, 2017-09-26
- 〈2탄, 웨이퍼 표면을 보호하는 산화공정〉, 《삼성반도체》, 2017-06-05
같이 보기[편집]

 위키원
위키원